半导体光刻胶专用化学品基本情况
相关报告
- 2015-2019年中国光刻胶用光引发剂行业市场深度剖析及投资前景趋势研究报告(2014-11-21)
- 2015-2019年中国光刻胶树脂行业市场深度调查研究及投资前景分析报告(2014-11-21)
- 2015-2019年中国PCB光刻胶行业市场深度调查分析及投资战略研究报告(2014-11-21)
- 2016-2022年中国LCD光刻胶行业市场深度调查研究及投资咨询报告(2015-11-28)
- 全国光刻胶树脂行业深度调查暨市场分析报告(2014-12-12)
- 2015-2020年中国光增感剂行业市场主要领域调查分析报告(2015-10-09)
- 2015-2020年中国光刻胶树脂行业市场主要领域调查分析报告(2015-10-14)
- 2015-2019年中国光刻胶树脂行业市场深度调查分析及投资战略研究报告(2014-11-21)
- 2015-2020年中国PCB光刻胶行业市场主要领域调查分析报告(2015-10-14)
- 全国光刻胶专用化学品行业深度调查暨市场分析报告(2014-12-10)
光刻胶在半导体集成电路生产工艺过程中起着举足轻重的作用。光刻是将掩膜版的电路结构临时复制到以后要进行刻蚀和离子注入的硅片上的工艺过程,图形的转移通过光刻胶来实现,光刻时转移到硅片上的各种各样的图形决定了器件的众多特性。集成电路各功能层是立体重叠的,大规模集成电路要经过约十几次光刻才能完成各层图形的全部传递。光刻胶的质量和性能是影响集成电路性能、成品率及可靠性的关键因素。光刻工艺的成本约为整个芯片制造工艺的35%,并且耗费时间约占整个芯片工艺的40%-60%。因此光刻胶是半导体集成电路制造的核心材料。
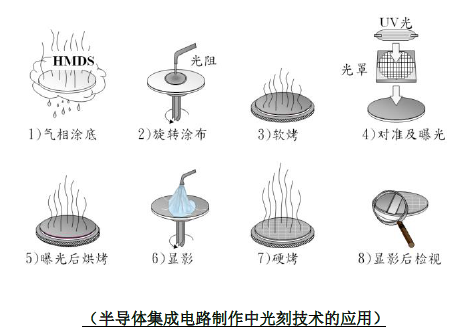
集成电路工业按照摩尔定律不断发展,即指集成电路上可容纳的晶体管数目,约每隔18个月便会增加一倍,性能也将提升一倍。集成电路水平已由微米级(1.0μm)、亚微米级(1.0~0.35μm)、深亚微米级(0.35μm以下)进入到纳米级(90~22nm)阶段,对光刻胶分辨率等性能的要求不断提高。缩短曝光波长和提高透镜的开口数(NA)可提高光刻胶的分辨率。光刻技术随着集成电路的发展,也经历了从g线(436nm)光刻,i线(365nm)光刻,到深紫外248nm光刻,及目前的193nm光刻的发展历程,相对应于各曝光波长的光刻胶也应运而生,光刻胶中的关键配方成份,如成膜树脂、光引发剂、添加剂也随之发生变化,使光刻胶的综合性能更好地满足工艺要求。目前集成电路制作中主要使用以下光刻胶: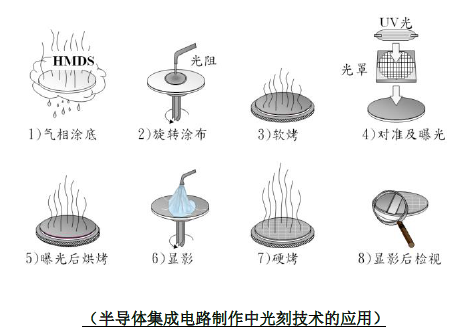
a.g线光刻胶对应曝光波长为436nm的g线,制作0.5μm以上的集成电路;i线光刻胶对应曝光波长为365nm的i线,制作0.5~0.35μm的集成电路;g线和i线光刻胶是目前市场上使用量最大的光刻胶,都以正性胶为主,主要原料为酚醛树脂和重氮萘醌化合物。g线和i线光刻胶只能对应现有半导体设备,今后随着老设备的逐渐淘汰,g线和i线光刻胶将逐渐萎缩。
b.KrF光刻胶对应曝光波长为248nm的KrF激光光源,制作0.25~0.15μm的集成电路,正性胶和负性胶都有,主要原料为聚对羟基苯乙烯及其衍生物和光致产酸剂。KrF光刻胶市场今后将逐渐扩大。
c.ArF光刻胶对应曝光波长为193nm的ArF激光光源,ArF干法制作65~130nm的集成电路,ArF浸湿法可以对应45nm以下集成电路制作。ArF光刻胶是正性胶,主要原料是聚脂环族丙烯酸酯及其共聚物和光致产酸剂。ArF光刻胶市场今后将快速成长。
集成电路中还要用到聚酰亚胺光刻胶,主要作用是缓和外部压力对芯片电路冲击及保护芯片表面。聚酰亚胺光刻胶分为正性胶和负性胶,主要原料中正性胶要用到光致产酸剂,负性胶中要用到光引发剂。
在所有的光刻胶化学品中,半导体光刻胶专用化学品对品质、纯度、杂质含量的要求是最严格的。
本文地址:http://www.zwzyzx.com/show-265-84585-1.html
相关资讯
- 全球农药市场进入成熟期,前景依然看好(2014-10-05)
- 电子气体市场规模分析(2016-10-18)
- 全球改性塑料行业大型国际化工集团跨国巨头(2014-12-21)
- 车用环保精细化学品上游尿素供给及价格情况(2015-06-17)
- 轻型输送带行业利润水平的变动趋势及原因(2015-04-17)
- 国内改性塑料行业主管部门和监管体制(2014-12-21)
- 国内染料中间体行业技术水平及其特点(2015-06-11)
- 至2020年革基布总需求量预计将达65.67亿米(2015-01-19)
合作媒体
最新报告
定制出版
热门报告
免责声明
中为咨询所引述的资料是用于行业市场研究以及讨论和交流,并注明出处,部分内容是由相关机构提供。若有异议请及时联系本公司,我们将立即依据相关法律对文章进行删除或作相应处理。查看详细》》



