MEMS封装工艺复杂,3D晶圆级封装是发展趋势
相关报告
- 2016-2022年中国电阻传感器行业市场深度调查研究及投资咨询报告(2015-12-03)
- 2015-2019年温度传感器项目商业计划书(2014-10-28)
- 2015-2020年中国智能交通设备行业市场主要领域调查分析报告(2015-09-16)
- 2015-2019年中国加速度传感器业兼并重组及投资建议研究分析报告(2014-11-05)
- 2014-2018年中国温度传感器行业市场深度剖析及投资前景趋势研究报告(2014-04-03)
- 2015-2020年中国工业测控传感器行业市场重点层面调查研究报告(2015-09-16)
- 2015-2020年中国电压传感器行业市场重点层面调查研究报告(2015-09-02)
- 2014-2018年中国光电传感器行业市场全面深度调查研究及投资研究报告(2014-04-03)
- 2014-2018年中国声波传感器行业市场发展研究及投资咨询研究报告(2014-04-03)
- 2016-2022年中国色标传感器区域行业市场调查研究及发展分析报告(2015-11-16)
在整个MEMS器件制造过程中,封装是后道工序。采用一定的材料以一定的形式将器件封装起来。MEMS封装提供多种功能,包括电源和信号通路、热管理、机械支撑以及环境和接口保护等。MEMS工艺可以与COMS工艺集成,带来SOC级的系统和架构,MEMS面临大量封装方面的挑战。
最佳的封装无疑可使得MEMS器件发挥出更好的性能。通常而言,MEMS封装应满足以下条件:一、可提供一个或多个环境通路;二、封装导致的应力应该尽量小;三、封装及材料最好不对环境造成不良影响;四、应不对其他器件造成不良影响;五、必须提供与外界通路。
MEMS晶圆级封装示意图
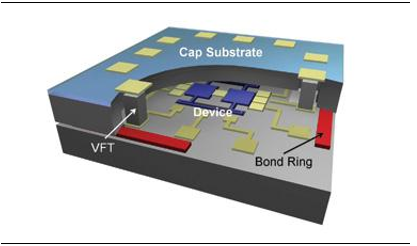
博世6轴电子罗盘封装结构
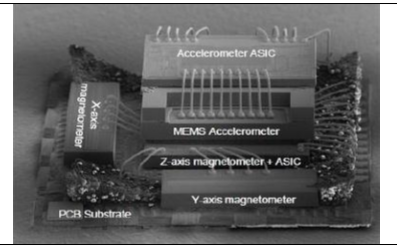
MEMS器件的封装方案基于对半导体知识体系的继承,然而,MEMS通常必须与操作环境接触,这是MEMS封装与IC封装最重要的区别。MEMS封装必须考虑可动结构以及与外部环境的接触。例如压力传感器,需要与周围环境直接接触,并且不同应用封装类型也不同。这对封装提出了新的要求,因为传统的集成电路中,芯片必须被完全保护起来以免受环境的影响。
MEMS压力传感器
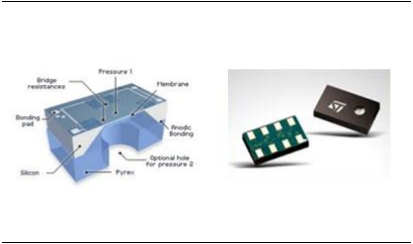
不同封装类型的压力传感器

有些MEMS传感器需要MEMS与ASIC集成起来进行封装,比如惯性传感器,MEMS封装难度与集成电路封装相比大幅的提升。
惯性传感器封装:MEMS+ASIC

集成电路封装与MEMS封装复杂度的比较

MEMS器件产生了新的复杂特性,在这些复杂特性的驱使下产生了新的封装方案。常见的封装方案有包覆式封装、具空腔的封装和预制式封装。MEMS器件有多种封装类型,如LGA、QFN、COL、FC等。
MEMS的封装类型
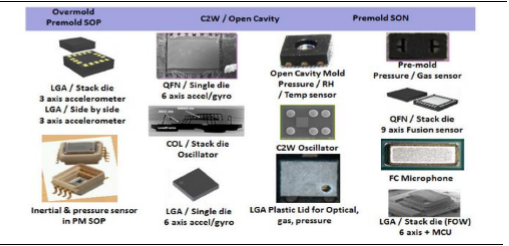
MEMS的封装方案及简化的封装流程
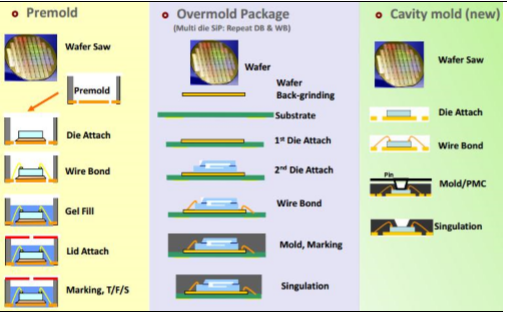
随着对封装尺寸越来越严格的规范,利用硅通孔(TSV)的3D晶圆级封装绝对是一个能使MEMS传感器集成度更高和更加智能化的解决方案。3D封装可以改善MEMS器件的尺寸、速度、能耗等多方面的性能,3D晶圆级封装正在成为可穿戴设备等应用“必须具有”的技术;晶圆级、TSV、3D是MEMS先进封装的发展趋势。
TSV技术

MEMS3D封装
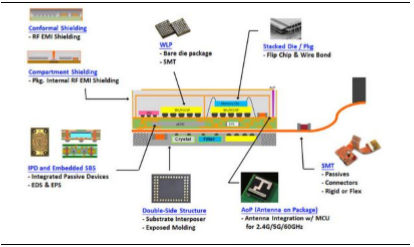
3D晶圆级封装流程

本文地址:http://www.zwzyzx.com/show-269-235658-1.html
相关资讯
- 新兴行业进一步打开数据中心市场空间(2015-05-03)
- 跨硬件平台全面渗透,Type-C是一个大生态(2016-10-08)
- 我国第三方支付行业的竞争格局:二维码支付(2016-06-23)
- 运营商开始加快推进双向网络改造和互动电视业务(2015-08-27)
- 区块链技术引导公证应用领域步入数字2.0时代(2016-06-29)
- 2013年度四川地区电信主要通信能力情况(2014-03-15)
- 智能手环产品竞争格局分析(2016-10-10)
- 国内,用户也想在电视上观赛(2016-04-19)
合作媒体
最新报告
定制出版
热门报告
免责声明
中为咨询所引述的资料是用于行业市场研究以及讨论和交流,并注明出处,部分内容是由相关机构提供。若有异议请及时联系本公司,我们将立即依据相关法律对文章进行删除或作相应处理。查看详细》》



